Разделы сайта
- Главная
- Исследования и анализ современных технологий
- IP-телефония
- Антенно-фидерные устройства
- Виртуальное построение рабочей локальной сети
- Влияние электромагнитного поля на подземную проволочную антенну
- Микрополосковая антенная решетка
- Система экологического мониторинга вредных газовых выбросов
- Организация процесса производства цифрового телевиденья
Картины на экране ДБЭ
Наиболее популярной технологией слежения за ходом нанесения слоев является дифракция быстрых электронов (ДБЭ) при их отражении от поверхности растущего слоя (отражательная дифракция высокоэнергичных электронов или RHEED в английской транскрипции) (рисунок 2.3.1). С ее помощью калибруют скорости роста слоев и температуру подложки, наблюдают удаление оксидов с поверхности подложки, определяют вид упорядочения поверхностных атомов и подходящее избыточное давление паров, обеспечивают обратную связь для управления источником в зависимости от состояния поверхности растущего слоя и получают информацию о кинетике роста слоя.
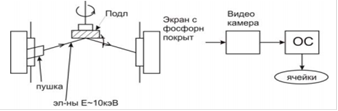
Рисунок 2.3.1 - Схема получения изображения растущего слоя путем дифракции быстрых электронов.
Электронная пушка ДБЭ эмитирует электроны с энергией около 10 КэВ, которые падают на поверхность под скользящим углом около 1 градуса. Затем электроны отражаются от нее, падают на экран с фосфорным покрытием и образуют здесь следующие 3 объекта: 1) дифракционный узор из светящихся пятен, 2) пятно зеркального отражения пучка от поверхности подложки, и 3) яркое пятно от электронов первичного пучка, совсем миновавших подложку. Изображение с экрана далее записывается на видеокамеру для записи всей картины или для слежения за изменением во времени интенсивности свечения одного из дифракционных пятен.

Рисунок 2.3.2 - Картина, полученная ДБЭ
Из вида дифракционной картины ДБЭ делают качественные выводы о состоянии поверхности. Если поверхность монокристаллическая и гладкая, то картина состоит из полос, перпендикулярных поверхности подложки (рисунок 2.3.2). При нарушении гладкости поверхности эти полосы разбиваются на отдельные пятна и тускнеют. Аморфная поверхность, например, слой окисла, дает туманное размытие вместо дифракционной картины. Поликристаллическая поверхность дает дифракционную картину, состоящую из колец, окружаюших пятно первичного пучка.
Кроме качественных выводов о состоянии поверхности дифракционная картина содержит и количественные данные об изменении параметра кристаллической решетки в ходе роста слоев. Например, таким способом было измерено 4% рассогласование параметров решеток Ge и Si при эпитаксиальном росте напряженных сплошных и островковых пленок GexSi1-x на подложках Si (100)[2].
Самое читаемое:
Диод Шоттки
Диод
Шоттки (также правильно Шотки, сокращённо ДШ) - с малым падением напряжения при
прямом включении. Назван в честь немецкого физика Вальтера Шоттки . Диоды
Шоттки используют переход металл-полупроводник в качестве барьера Шоттки (вместо
p-n перехода , как у обычных диодов). Допустимое обратное напряжение
промышленно выпускаемы ...